AI 시대의 진짜 병목 — OSAT 후공정 패키징 전쟁
CoWoS 캐파 13배에도 부족한 시대, 패키징 병목이 만든 OSAT 수혜의 구조
핵심 요약
AI 시대의 진짜 병목은 GPU 칩이 아니라 패키징이다. NVIDIA H100·B200·Rubin과 AMD MI300/350/400, Google TPU, AWS Trainium까지 모든 AI 가속기가 통과해야 하는 단일 관문이 TSMC의 CoWoS이며, TSMC가 캐파를 13배 늘렸음에도 NVIDIA 한 회사가 50%+를 단독 부킹할 만큼 부족하다. 이 여파로 2025년부터 Amkor·ASE·SPIL이 외주 캐파를 받기 시작했고, 2026년부터는 OSAT 빅3가 AI 인프라 밸류체인의 정식 멤버로 편입됐다. MediaTek CEO Rick Tsai가 ISSCC 2026년 2월에서 발언한 "메모리·패키징이 XPU BOM의 약 50%를 차지한다"는 한 줄이 이 산업의 실체를 압축한다 — 패키징은 더 이상 "마무리 작업"이 아니라 칩 가격의 절반과 성능의 절반을 결정하는 영역이다.
한국 노출은 두 통로를 갖는다. 메모리 후공정 외주(하나마이크론·SFA반도체)와 HBM 장비(한미반도체 TC Bonder)다. OSAT 본진인 ASE·Amkor에는 한국 입지가 약하지만, SK하이닉스·삼성의 HBM 집중 전략이 만든 외주 흐름과 한미반도체의 글로벌 70%+ TC Bonder 점유율이 한국을 산업의 변방이 아닌 핵심 부품 공급자로 자리매김하게 했다. 단 ASMPT의 SK하이닉스 HBM4 본더 발주(2025년 12월) + 한미-한화 특허 분쟁이 한미반도체의 SK하이닉스向 점유율을 2026년 20~30%로 압박하면서 "한국 챔피언"의 정의가 다시 쓰여지는 시점이다.
📌 한 줄 결론 — AI는 칩 부족이 아니라 패키징 부족이며, 한국은 OSAT 본진에는 변방이지만 HBM 장비(한미반도체)와 메모리 외주(하나마이크론) 두 축으로 패키징 병목 수혜를 분산 노출한다.
CoWoS — AI 시대의 진짜 병목
AI 가속기는 일반 칩과 근본적으로 다르다. 일반 CPU는 다이 50~200mm²에 메모리(DIMM)가 별도, 패키징은 Flip Chip 기준 ~$1 미만이다. AI GPU는 다이 800mm²+에 메모리(HBM)가 같은 패키지 안에 적층되며, 데이터 통로가 수천 개(TSV), 패키징은 CoWoS 2.5D 기준 $50~$150에 수율 70~85%까지 떨어진다. 이 차이가 OSAT 산업의 위상을 바꿨다 — 메모리와 GPU를 한 패키지로 묶을 수 있는 곳은 TSMC + 극소수 OSAT뿐이고, 캐파 자체가 한정되어 있다.
패키징 기술의 진화 — 14년 만에 3,000배 비용 점프

_<Chart 1> 패키징 기술 진화 — Wire Bond부터 Hybrid Bonding까지_
| 기술 | 시기 | 특징 | 비용/칩 | 대표 응용 |
|---|---|---|---|---|
| Wire Bond | ~2010 | 와이어로 연결 | ~$0.05 | 기본 메모리, 저가 칩 |
| Flip Chip | ~2015 | 범프로 직접 연결 | ~$0.5 | 스마트폰 AP |
| CoWoS-S | 2020~ | GPU + HBM 결합(실리콘 인터포저) | ~$50 | NVIDIA H100, B100 |
| CoWoS-L | 2024~ | LSI 브리지로 더 큰 칩 | ~$80 | NVIDIA Rubin |
| Hybrid Bonding | 2027+ | 솔더 없는 직접 본딩(원자 단위) | ~$150 | HBM4+, 차세대 GPU |
- 시기
- ~2010
- 특징
- 와이어로 연결
- 비용/칩
- ~$0.05
- 대표 응용
- 기본 메모리, 저가 칩
- 시기
- ~2015
- 특징
- 범프로 직접 연결
- 비용/칩
- ~$0.5
- 대표 응용
- 스마트폰 AP
- 시기
- 2020~
- 특징
- GPU + HBM 결합(실리콘 인터포저)
- 비용/칩
- ~$50
- 대표 응용
- NVIDIA H100, B100
- 시기
- 2024~
- 특징
- LSI 브리지로 더 큰 칩
- 비용/칩
- ~$80
- 대표 응용
- NVIDIA Rubin
- 시기
- 2027+
- 특징
- 솔더 없는 직접 본딩(원자 단위)
- 비용/칩
- ~$150
- 대표 응용
- HBM4+, 차세대 GPU
패키징 한 번 비용이 14년 만에 ~$0.05에서 ~$150으로 약 3,000배 점프했다. 이는 OSAT 산업이 칩 가치 사슬에서 차지하는 비중이 그만큼 커졌다는 의미이며, 마진과 매출이 동시에 폭발하는 직접 동력이다.
CoWoS 변종 S·R·L — 차세대는 CoWoS-L
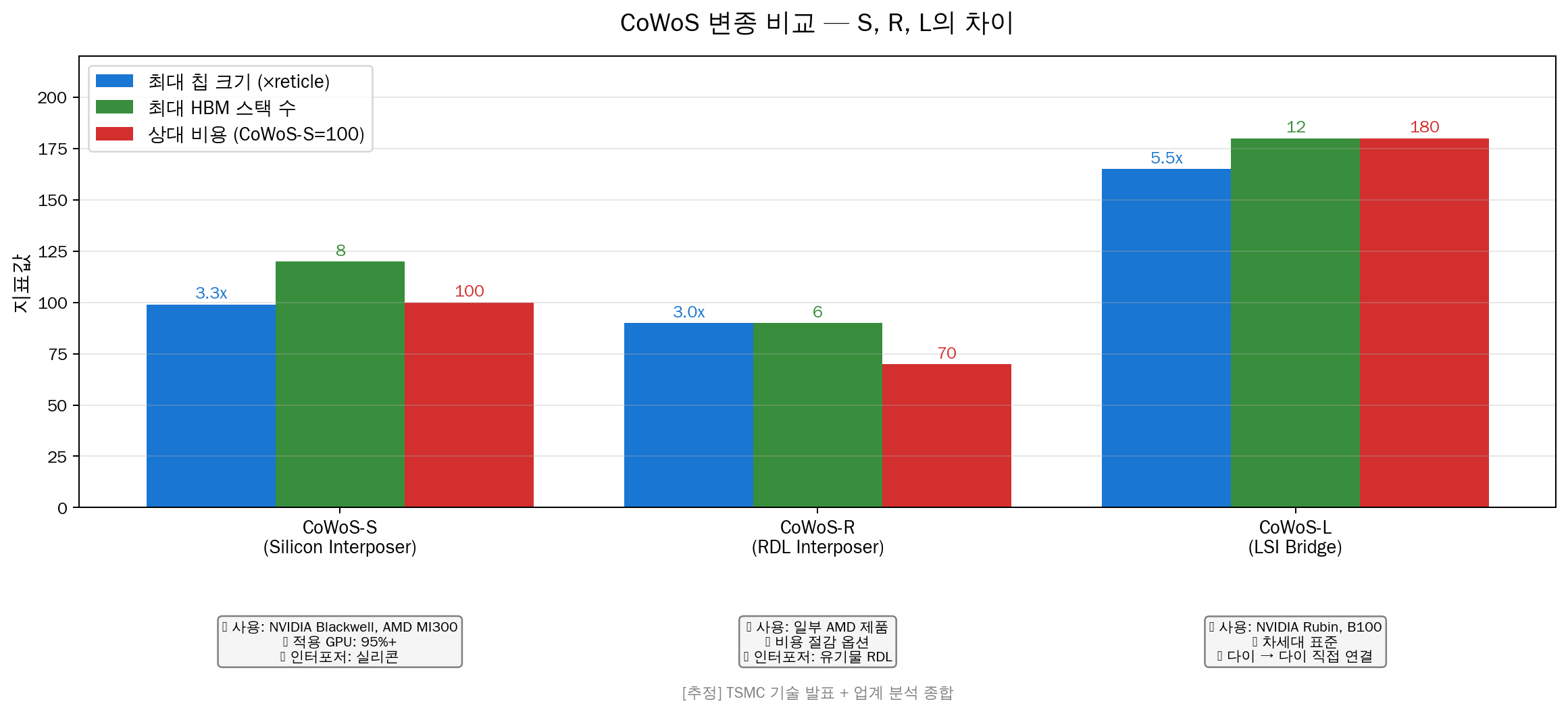
_<Chart 2> CoWoS 변종 비교_
| 변종 | 인터포저 | 최대 칩 크기 | 최대 HBM | 대표 사용처 |
|---|---|---|---|---|
| CoWoS-S | 실리콘 | 3.3x reticle | 8개 | NVIDIA H100, AMD MI300 |
| CoWoS-R | 유기물 RDL | 3.0x reticle | 6개 | AMD 일부 |
| CoWoS-L | LSI 브리지 | 5.5x reticle | 12개 | NVIDIA Rubin, B100 |
- 인터포저
- 실리콘
- 최대 칩 크기
- 3.3x reticle
- 최대 HBM
- 8개
- 대표 사용처
- NVIDIA H100, AMD MI300
- 인터포저
- 유기물 RDL
- 최대 칩 크기
- 3.0x reticle
- 최대 HBM
- 6개
- 대표 사용처
- AMD 일부
- 인터포저
- LSI 브리지
- 최대 칩 크기
- 5.5x reticle
- 최대 HBM
- 12개
- 대표 사용처
- NVIDIA Rubin, B100
현재 CoWoS-S가 95%+ 점유율이며, 2026년부터 CoWoS-L이 본격화된다. CoWoS-L은 더 큰 다이와 더 많은 HBM을 가능하게 해 차세대 AI 칩(NVIDIA Rubin·B100, 차세대 AMD MI400)에 필수적이다.
CoWoS 캐파 — 3년 만에 13배 증가, 그래도 부족

_<Chart 3> CoWoS 캐파 폭증 — 2023~2027 추이_
| 시기 | TSMC 캐파 | OSAT 캐파 | 총합 | 주요 내용 |
|---|---|---|---|---|
| 2023년 1분기 | 10K/월 | 0 | 10K | CoWoS 본격 시작 |
| 2024년 1분기 | 22K/월 | 0 | 22K | NVIDIA H100 폭주 |
| 2025년 1분기 | 55K/월 | 5K | 60K | OSAT 외주 시작 |
| 2026년 1분기 | 95K/월 | 18K | 113K | NVIDIA 50% 부킹 |
| 2026년 4분기 | 130K/월 | 30K | 160K | OSAT 외주 본격화 |
| 2027년 추정 | 170K/월 | 50K | 220K | CoWoS-L 주류 |
- TSMC 캐파
- 10K/월
- OSAT 캐파
- 0
- 총합
- 10K
- 주요 내용
- CoWoS 본격 시작
- TSMC 캐파
- 22K/월
- OSAT 캐파
- 0
- 총합
- 22K
- 주요 내용
- NVIDIA H100 폭주
- TSMC 캐파
- 55K/월
- OSAT 캐파
- 5K
- 총합
- 60K
- 주요 내용
- OSAT 외주 시작
- TSMC 캐파
- 95K/월
- OSAT 캐파
- 18K
- 총합
- 113K
- 주요 내용
- NVIDIA 50% 부킹
- TSMC 캐파
- 130K/월
- OSAT 캐파
- 30K
- 총합
- 160K
- 주요 내용
- OSAT 외주 본격화
- TSMC 캐파
- 170K/월
- OSAT 캐파
- 50K
- 총합
- 220K
- 주요 내용
- CoWoS-L 주류
가장 중요한 변곡점은 2025년이다 — 처음으로 OSAT(Amkor·ASE·SPIL)이 CoWoS 캐파에 합류했다. TSMC 자체 캐파가 부족해서 외주를 줄 수밖에 없는 시점이 도래한 것이며, 이는 OSAT 산업이 AI 인프라 밸류체인의 부수적 지원자에서 정식 멤버로 격상되는 신호다.
NVIDIA의 CoWoS 분배 + OSAT 외주의 본격화
NVIDIA는 2026년 CoWoS 캐파 약 595K wafer(연간)를 단독으로 부킹했다. 이는 글로벌 CoWoS 총 캐파의 50%+를 한 회사가 가져간다는 뜻이며, 패키징이 GPU 출하를 결정하는 단일 변수임을 입증한다.

_<Chart 4> NVIDIA 2026 CoWoS 분배도_
TSMC 자체 510K (86%) — Blackwell Ultra(GB300), Rubin 등 핵심 GPU
Amkor 외주 60K (10%) — Vera CPU, 일부 자동차 ASIC
ASE/SPIL 외주 25K (4%) — 자동차 칩, 검증용 GPU
패턴은 명확하다. 가장 핵심·민감한 칩은 TSMC 자체 라인에 머물고(NVIDIA 코어 GPU·Apple AI·Meta·OpenAI 100%), 보조·검증·자동차 칩이 OSAT으로 넘어온다. 그러나 그 14% 외주가 글로벌 OSAT 매출에는 의미 있는 규모로, Amkor 연 매출의 약 10%를 기여한다.
다른 고객들의 OSAT 활용 — Broadcom·Google이 핵심
| 고객 | TSMC 자체 (K) | OSAT 외주 (K) | 외주 비중 |
|---|---|---|---|
| NVIDIA | 510 | 85 | 15% |
| Google TPU | 85 | 5 | 6% |
| AMD | ~60 | ~5 | 8% |
| Broadcom (네트워킹) | ~30 | 10 | 25% |
| Apple AI 가속기 | ~40 | 0 | 0% |
| Meta | 50 | 0 | 0% |
| OpenAI | 10 | 0 | 0% |
- TSMC 자체 (K)
- 510
- OSAT 외주 (K)
- 85
- 외주 비중
- 15%
- TSMC 자체 (K)
- 85
- OSAT 외주 (K)
- 5
- 외주 비중
- 6%
- TSMC 자체 (K)
- ~60
- OSAT 외주 (K)
- ~5
- 외주 비중
- 8%
- TSMC 자체 (K)
- ~30
- OSAT 외주 (K)
- 10
- 외주 비중
- 25%
- TSMC 자체 (K)
- ~40
- OSAT 외주 (K)
- 0
- 외주 비중
- 0%
- TSMC 자체 (K)
- 50
- OSAT 외주 (K)
- 0
- 외주 비중
- 0%
- TSMC 자체 (K)
- 10
- OSAT 외주 (K)
- 0
- 외주 비중
- 0%
Broadcom이 핵심이다. 네트워킹 칩에서 25%까지 OSAT 외주를 활용하며, 이는 주로 Amkor가 받는 물량이다. Amkor의 K5(인천)·애리조나 팹이 직접 수혜자다.
Amkor의 K5 인천 — 글로벌 첨단 패키징 거점화
Amkor의 한국 K5(인천 송도) 팹은 TSMC CoWoS-S 외주 + Intel EMIB + Apple WMCM + Google TPU 일부를 동시에 운영하면서 글로벌 첨단 패키징의 핵심 거점이 됐다. 한국 우수 반도체 인력 + 대만 의존도 분산 효과 + 미국 본사와의 거리 + 한국 정부의 첨단 패키징 지원이 합쳐진 결과다. NVIDIA의 "primarily Amkor" 패턴(JPMorgan TSMC CoWoS 리포트)이 K5의 위상을 단적으로 보여준다.
글로벌 OSAT 시장 구조 — 대만 압도, 미국·중국 추격
글로벌 OSAT 시장은 대만 45.9% 압도, 중국 20% 부상, 미국 Amkor 13.4% 단독, 한국 4% 변방의 구조를 보인다.

_<Chart 5> 글로벌 OSAT TOP 10 시장 점유율 (2024)_
지역별 분포
| 지역 | 주요 기업 | 합산 점유율 | 특징 |
|---|---|---|---|
| 대만 | ASE, SPIL, PTI, KYEC | 45.9% | 글로벌 OSAT 본진 |
| 중국 | JCET, TFME, Tongfu, ChipMOS | 20.0% | 내수 + 정부 지원 |
| 미국 | Amkor | 13.4% | NVIDIA·Apple 핵심 |
| 한국 | 하나마이크론, SFA반도체, 네패스아크 | 4.0% | 메모리 외주 특화 |
| 일본 | Sumco Tech, Renesas 후공정 | <2% | 자동차 특화 |
| 싱가포르 | UTAC | ~1.5% | M&A 후 통합 진행 중 |
- 주요 기업
- ASE, SPIL, PTI, KYEC
- 합산 점유율
- 45.9%
- 특징
- 글로벌 OSAT 본진
- 주요 기업
- JCET, TFME, Tongfu, ChipMOS
- 합산 점유율
- 20.0%
- 특징
- 내수 + 정부 지원
- 주요 기업
- Amkor
- 합산 점유율
- 13.4%
- 특징
- NVIDIA·Apple 핵심
- 주요 기업
- 하나마이크론, SFA반도체, 네패스아크
- 합산 점유율
- 4.0%
- 특징
- 메모리 외주 특화
- 주요 기업
- Sumco Tech, Renesas 후공정
- 합산 점유율
- <2%
- 특징
- 자동차 특화
- 주요 기업
- UTAC
- 합산 점유율
- ~1.5%
- 특징
- M&A 후 통합 진행 중
비즈니스 모델 비교 — 마진 30%+는 Advanced Packaging만
| 카테고리 | 주요 사업 | 대표 기업 | 마진 |
|---|---|---|---|
| Logic OSAT | GPU/CPU/AP 패키징·테스트 | ASE, Amkor, SPIL | 15-25% |
| Memory OSAT | D램/낸드 외주 | 하나마이크론, SFA반도체, JCET | 5-15% |
| Substrate | BGA/FCBGA 기판 | Unimicron, Ibiden, AT&S | 10-20% |
| Test | 범프, 테스트 단독 | KYEC, ChipMOS | 20-30% |
| Advanced Packaging | CoWoS, FOWLP, 3D | TSMC + Amkor + ASE | 30%+ |
- 주요 사업
- GPU/CPU/AP 패키징·테스트
- 대표 기업
- ASE, Amkor, SPIL
- 마진
- 15-25%
- 주요 사업
- D램/낸드 외주
- 대표 기업
- 하나마이크론, SFA반도체, JCET
- 마진
- 5-15%
- 주요 사업
- BGA/FCBGA 기판
- 대표 기업
- Unimicron, Ibiden, AT&S
- 마진
- 10-20%
- 주요 사업
- 범프, 테스트 단독
- 대표 기업
- KYEC, ChipMOS
- 마진
- 20-30%
- 주요 사업
- CoWoS, FOWLP, 3D
- 대표 기업
- TSMC + Amkor + ASE
- 마진
- 30%+
Advanced Packaging은 마진 30%+ 영역이며, AI 시대 모든 기업이 진입 경쟁 중이다. TSMC가 압도적 1위, OSAT 중 인증된 회사는 Amkor·ASE 단 둘이다.
ASE Technology — 글로벌 OSAT 1위
시가총액 약 $240B(2026년 4월), 2025 매출 NT$ 389B(약 $12.5B, +19% YoY), 2025 영업이익률 11.3%, 4분기 14.7%. 패키징 매출 비중 80.1%, 테스트 18.5%로 풀라인 운영. AI 매출은 약 $1.6B(2025)로, 그 중 75%가 패키징·25%가 테스트다.
주요 고객은 NVIDIA·AMD·Apple·Qualcomm·Broadcom·MediaTek. CoWoS 외주 캐파를 2026년 말 월 20~25K wafer로 확대 목표이며, 자체 차세대 패키징인 VIPack(Vertical Interconnect Packaging)·CoWoP(Chip-on-Wafer-on-Panel)을 개발 중이다. NVIDIA Vera CPU·자동차 칩(Drive Thor) 외주 본격화가 2026년 핵심 동력이다.
Amkor — 미국 단독 OSAT, K5 거점
시가총액 약 $9.0B(2026년 4월), 2025 매출 약 $7.2B 추정. 글로벌 점유율 13.4%로 2위. 핵심 팹은 K5(한국 인천), 베트남, 포르투갈, 애리조나. 주요 고객은 NVIDIA·Apple·Qualcomm·Broadcom·Intel(EMIB)·Google.
Amkor의 2026 CoWoS 외주 캐파는 월 15~16K wafer로 연간 180~190K 규모다. 핵심 외주 물량은 NVIDIA Vera CPU·자동차(40K → 60K → 85K) + Broadcom 네트워킹 ASIC(5K → 10K → 70K) + Google TPU 일부(0K → 5K → 15K)로, 2027년에 연간 200K로 폭발 성장 전망(JPMorgan 모델).
SPIL·PTI(대만) + JCET(중국)
SPIL — ASE 자회사이지만 별도 통계, 점유율 8%, NVIDIA Validation 통과 OSAT, CoWoS 외주 월 5~7K wafer. PTI(Powertech) — 점유율 5.8%, 메모리 패키징 특화(50%), 삼성·SK하이닉스·Micron 외주 핵심, 한국 OSAT(하나마이크론·SFA반도체)의 직접 경쟁자. JCET — 중국 1위, 점유율 12%, 정부 지원 + 내수 시장 + Wuxi 첨단 패키징 라인으로 한국 메모리 외주에 직접 경쟁 압박.
한국 OSAT 듀얼 트랙 — 하나마이크론 · SFA반도체
한국 OSAT은 글로벌 점유율 4%로 변방이지만, 메모리 3사 HBM 집중의 반사이익을 직접 받는 두 회사 — 하나마이크론과 SFA반도체 — 가 빠르게 부상하고 있다.

_<Chart 6> 한국 OSAT Top 2 실적 비교_
하나마이크론 — SK하이닉스 D램 외주의 직접 수혜
시가총액 약 1조 원(2026년 4월), 2025 매출 1.52조 원·영업이익 1,440억 원(OPM 9.5%) 추정, 2026 컨센서스 매출 1.97조 원(+30% YoY)·영업이익 2,316억 원(+74% YoY). 주요 고객은 SK하이닉스(60%+), 삼성전자, 글로벌 고객.
핵심은 베트남 V2 공장이다. SK하이닉스와 2021년 체결한 메모리 후공정 외주임가공계약에 따라 구축됐고, SK하이닉스가 HBM 캐파 집중을 위해 범용 D램 외주를 늘리면서 V2가 폭발 성장했다.
| 연도 | V2 매출 | YoY | 설명 |
|---|---|---|---|
| 2022 | 227억 원 | - | 시범 가동 |
| 2023 | ~600억 원 | +165% | 본격 가동 시작 |
| 2024 | 3,374억 원 | +462% | 대량 외주 시작 |
| 2025 추정 | ~6,500억 원 | +93% | 풀 가동 |
| 2026 추정 | ~9,000억 원 | +38% | 추가 라인 증설 가능 |
- V2 매출
- 227억 원
- YoY
- -
- 설명
- 시범 가동
- V2 매출
- ~600억 원
- YoY
- +165%
- 설명
- 본격 가동 시작
- V2 매출
- 3,374억 원
- YoY
- +462%
- 설명
- 대량 외주 시작
- V2 매출
- ~6,500억 원
- YoY
- +93%
- 설명
- 풀 가동
- V2 매출
- ~9,000억 원
- YoY
- +38%
- 설명
- 추가 라인 증설 가능
4년 만에 약 30배 매출 폭증. 이는 SK하이닉스의 HBM 집중 전략이 만들어낸 구조적 외주 흐름의 직접 결과이며, 단순 사이클 회복이 아니라 메모리 빅2의 "고부가 자체 + 범용 외주" 전략의 산물이다.
SFA반도체 — 삼성 메모리 외주 + 필리핀 회복
시가총액 약 6,500억 원, 글로벌 OSAT 점유율 1.4%. 2023~2024년 메모리 다운사이클로 적자에 빠졌으나, 2025년 하반기부터 본격 회복했다. 필리핀 공장 가동률이 30%대에서 60%대로 회복됐고, 2026년 1분기 흑자 전환이 전망된다. 삼성이 HBM 생산을 늘리면서 기존 DDR5 테스트 설비 120대가 필리핀으로 이전됐고, 모듈 라인 5개가 추가 배정됐다. 2025년 투자한 비메모리 플립칩 설비가 2026년 하반기부터 매출 반영될 예정이다.
하나마이크론 vs SFA반도체 비교
| 항목 | 하나마이크론 | SFA반도체 |
|---|---|---|
| 핵심 고객 | SK하이닉스 60%+ | 삼성전자 핵심 |
| 핵심 거점 | 베트남 V2 | 필리핀 |
| 2025 OPM | 9.5% | 흑자전환 (1Q26 전망) |
| AI 매출 비중 | 70% | 12% |
| 자체 첨단 기술 | HIC(2.5D) 개발 중 | 비메모리 플립칩 신규 |
- 하나마이크론
- SK하이닉스 60%+
- SFA반도체
- 삼성전자 핵심
- 하나마이크론
- 베트남 V2
- SFA반도체
- 필리핀
- 하나마이크론
- 9.5%
- SFA반도체
- 흑자전환 (1Q26 전망)
- 하나마이크론
- 70%
- SFA반도체
- 12%
- 하나마이크론
- HIC(2.5D) 개발 중
- SFA반도체
- 비메모리 플립칩 신규
하나마이크론은 SK하이닉스 의존도가 양날의 검이지만 V2 베트남의 저원가 구조 + AI 매출 70%로 한국 OSAT 중 최고 노출이다. SFA반도체는 회복 속도가 더 느리지만 삼성의 비메모리 플립칩 신규 투자 본격화 시 추가 동력이 가능하다. 둘 다 단일 고객 리스크와 메모리 사이클 노출이 핵심 변수다.
한미반도체 — TC Bonder 챔피언과 SK하이닉스 점유율 분기점
한국의 진짜 챔피언은 OSAT이 아니라 HBM 적층 장비 1위 한미반도체다. OSAT은 아니지만 OSAT 가치사슬에서 가장 중요한 장비를 만드는 회사로, 메모리 IDM(SK하이닉스·삼성)의 직접 공급자라는 위치를 점하고 있다.

_<Chart 7> HBM 패키징 5단계 밸류체인_
HBM 패키징 5단계 밸류체인
Step 1 (메모리 칩 제조): SK하이닉스·삼성·Micron이 D램 칩 8장(또는 12·16장) 제작
Step 2 (HBM 적층): TC Bonder로 칩-칩 본딩 — 한미반도체 글로벌 70%+
Step 3 (CoWoS 본딩): GPU + HBM을 인터포저 위에 올림 — TSMC + Amkor·ASE
Step 4 (기판 부착): BGA 기판에 부착 — Unimicron·Ibiden·AT&S
Step 5 (테스트): 모든 칩 정상 작동 검증 — 다양한 OSAT + 한국 강자
한국이 진짜 강한 영역은 Step 1(HBM 메모리) + Step 2(TC Bonder) + Step 5(테스트)의 세 축이며, Step 3(CoWoS)는 TSMC·Amkor의 영역으로 한국 직접 진입이 어렵다.
한미반도체 — TC Bonder 글로벌 70%+ 챔피언

_<Chart 8> 한미반도체 — TC Bonder 글로벌 챔피언_
| 항목 | 내용 |
|---|---|
| 시가총액 | 약 27조 원(2026년 4월) |
| 주력 제품 | HBM TC Bonder, Dual TC Bonder, Hybrid Bonder |
| 글로벌 점유율 | 70%+ (TC Bonder) |
| 주요 고객 | SK하이닉스, 삼성전자, 향후 Micron |
| 2025 매출 | 약 7,500억 원 |
| 2026 매출 컨센서스 | 약 1조 원+ (HBM4 본격화) |
| 영업이익률 | 47%+ |
TC Bonder는 D램 칩 8장(또는 12·16장)을 마이크로미터 단위로 정확히 쌓고 그 사이를 수천 개 미세 통로(TSV)로 연결하는 장비다. 칩과 칩을 정확한 위치에 정렬해 고온·고압으로 접합하는데, 이 시장에서 한미반도체가 70%+를 점유하며, 경쟁사는 네덜란드 BESI(18%), 일본 Shinkawa(8%) 정도다.
SK하이닉스 점유율의 분기점 — 2025년 12월 ASMPT 진입
한미반도체의 SK하이닉스向 TC Bonder 점유율은 2026년에 큰 변곡점을 맞이한다. SK하이닉스가 2025년 12월 ASMPT에 HBM4 TC Bonder 발주를 정식으로 시작했고, 현재 HBM4 라인의 TC Bonder 약 50대 중 절반이 ASMPT 공급으로 추정된다(TrendForce 2025-12). 같은 시기 한미반도체와 한화세미텍 사이의 특허 분쟁이 격화되면서 SK하이닉스의 공급 다변화 압박을 키웠다.
한미반도체의 SK하이닉스向 점유율은 2026년 20~30%로 분할 전망이다(lumenalpha·digitimes). 글로벌 TC Bonder 시장 70%+ 점유 자체는 견고하지만, 단일 최대 고객인 SK하이닉스에서의 점유율은 ASMPT·BESI에 의해 분할되는 흐름이며, 한미반도체의 자체 Hybrid Bonder 신제품(HBM5 시점 양산 목표)이 다음 라운드의 핵심 변수다.
Step 5 — 한국 테스트의 분산된 강자들
Step 5(테스트) 영역에서는 한국이 다양한 specialty로 분산 강점을 가진다. 두산테스나가 시스템 반도체·AI 테스트(NVIDIA H100 등)를 담당하고, 네패스아크가 FOWLP 패키징과 테스트, 테크윙이 HBM 테스트 핸들러, 리노공업이 AI 테스트 핀, ISC가 AI 테스트 소켓, 티에스이가 테스트 인터페이스를 맡는다. 그 외 글로벌에서는 Advantest가 ATE 1위(메모리·SoC 테스터, AI 70% 매출), FormFactor가 프로브카드 글로벌 리더, Aehr Test가 SiC·HBM 번인 specialty 위치다.
한국 투자 관점에서 Step 5 노출은 다양하지만 분산된 specialty 모음으로, 단일 종목 베팅보다는 테스트 포트폴리오 노출이 효율적이다.
OSAT AI 노출도 + 한국 패키징 매트릭스
OSAT 기업별 AI 매출 비중을 비교하면 하나마이크론이 70%로 1위, Amkor 55%, ASE 35% 순이며, 절대 규모는 ASE·Amkor가 압도하지만 노출도 측면에서는 한국 메모리 OSAT이 더 집중되어 있다.

_<Chart 9> OSAT 기업별 AI 매출 비중 (2025 추정)_
| 기업 | AI 매출 비중 | 절대 규모 (AI 매출) | 핵심 동력 |
|---|---|---|---|
| 하나마이크론 | 70% | 약 $0.8B | SK하이닉스 D램·HBM 외주 |
| Amkor | 55% | 약 $3.9B | NVIDIA·Broadcom CoWoS 외주 |
| ASE | 35% | 약 $4.4B | NVIDIA·AMD·Marvell |
| SPIL | 30% | 약 $1.0B | NVIDIA Validation |
| PTI | 22% | 약 $0.5B | 메모리 OSAT |
| JCET | 18% | 약 $0.4B | 중국 내수 + Huawei |
| SFA반도체 | 12% | 약 $0.05B | 삼성 메모리 외주 |
- AI 매출 비중
- 70%
- 절대 규모 (AI 매출)
- 약 $0.8B
- 핵심 동력
- SK하이닉스 D램·HBM 외주
- AI 매출 비중
- 55%
- 절대 규모 (AI 매출)
- 약 $3.9B
- 핵심 동력
- NVIDIA·Broadcom CoWoS 외주
- AI 매출 비중
- 35%
- 절대 규모 (AI 매출)
- 약 $4.4B
- 핵심 동력
- NVIDIA·AMD·Marvell
- AI 매출 비중
- 30%
- 절대 규모 (AI 매출)
- 약 $1.0B
- 핵심 동력
- NVIDIA Validation
- AI 매출 비중
- 22%
- 절대 규모 (AI 매출)
- 약 $0.5B
- 핵심 동력
- 메모리 OSAT
- AI 매출 비중
- 18%
- 절대 규모 (AI 매출)
- 약 $0.4B
- 핵심 동력
- 중국 내수 + Huawei
- AI 매출 비중
- 12%
- 절대 규모 (AI 매출)
- 약 $0.05B
- 핵심 동력
- 삼성 메모리 외주
비중과 절대 규모는 다른 게임이다. ASE·Amkor가 절대 규모는 압도하지만, 하나마이크론은 비중 1위로 "메모리 OSAT인데 HBM 시대의 직접 수혜를 받는 구조"라는 독특한 위치에 있다.
한국 OSAT/패키징 밸류체인 매트릭스 — 4분면 분석

_<Chart 10> 한국 OSAT/패키징 매트릭스_
| 사분면 | AI 노출도 | 단일 고객 의존도 | 대표 기업 |
|---|---|---|---|
| 1. 고노출·고의존 | 高 | 高 | 하나마이크론 (SK하이닉스) |
| 2. 고노출·저의존 | 高 | 低 | 한미반도체 (SK·삼성·향후 Micron) |
| 3. 저노출·고의존 | 低 | 高 | SFA반도체 (삼성) |
| 4. 저노출·저의존 | 低 | 低 | 네패스아크, 두산테스나 |
- AI 노출도
- 高
- 단일 고객 의존도
- 高
- 대표 기업
- 하나마이크론 (SK하이닉스)
- AI 노출도
- 高
- 단일 고객 의존도
- 低
- 대표 기업
- 한미반도체 (SK·삼성·향후 Micron)
- AI 노출도
- 低
- 단일 고객 의존도
- 高
- 대표 기업
- SFA반도체 (삼성)
- AI 노출도
- 低
- 단일 고객 의존도
- 低
- 대표 기업
- 네패스아크, 두산테스나
투자 관점에서 가장 매력적 사분면은 2번이며, 한미반도체가 대표다. 고AI 노출 + 저의존(다중 고객 + Micron 진입 잠재력)으로 단일 IDM 정책 변동 리스크가 가장 낮다. 1번 사분면(하나마이크론)은 노출도가 가장 높지만 단일 고객 리스크가 크고, 3번(SFA반도체)은 회복 사이클의 베타가 있지만 의존도가 높다.
한국 핵심 기업 종합 비교
| 기업 | 시총 | 핵심 사업 | AI 매출 비중 | 2026 컨센 OPM | 단일 고객 의존도 |
|---|---|---|---|---|---|
| 한미반도체 | 약 27조 | TC Bonder | 80%+ | 47%+ | 중(SK 중심) |
| 하나마이크론 | 약 1조 | 메모리 OSAT | 70% | 11~12% | 高(SK 60%+) |
| SFA반도체 | 약 6,500억 | 메모리 OSAT | 12% | 회복 단계 | 高(삼성) |
| 이오테크닉스 | 약 3.5조 | 레이저 장비 | 35% | 18% | 중(SK·TSMC) |
| 네패스아크 | 약 5,000억 | FOWLP·테스트 | 25% | 15% | 분산 |
- 시총
- 약 27조
- 핵심 사업
- TC Bonder
- AI 매출 비중
- 80%+
- 2026 컨센 OPM
- 47%+
- 단일 고객 의존도
- 중(SK 중심)
- 시총
- 약 1조
- 핵심 사업
- 메모리 OSAT
- AI 매출 비중
- 70%
- 2026 컨센 OPM
- 11~12%
- 단일 고객 의존도
- 高(SK 60%+)
- 시총
- 약 6,500억
- 핵심 사업
- 메모리 OSAT
- AI 매출 비중
- 12%
- 2026 컨센 OPM
- 회복 단계
- 단일 고객 의존도
- 高(삼성)
- 시총
- 약 3.5조
- 핵심 사업
- 레이저 장비
- AI 매출 비중
- 35%
- 2026 컨센 OPM
- 18%
- 단일 고객 의존도
- 중(SK·TSMC)
- 시총
- 약 5,000억
- 핵심 사업
- FOWLP·테스트
- AI 매출 비중
- 25%
- 2026 컨센 OPM
- 15%
- 단일 고객 의존도
- 분산
차세대 패키징 — CPO · Hybrid Bonding · FOPLP
현재의 CoWoS 시대를 잇는 차세대 패키징 변화는 2026~28에 동시 변곡점을 맞이하면서 산업 지도를 한 번 더 재편할 예정이다. 4대 변화는 CoWoS-L · CPO · Hybrid Bonding · FOPLP다.
CPO(Co-Packaged Optics) — 광통신의 패키지 통합
기존 AI 서버는 칩 사이를 구리(Copper) 케이블로 연결하지만 데이터 양 폭증으로 한계에 도달했다(전력·발열·대역폭). 해결책은 광통신으로, CPO는 광 트랜시버를 패키지 안에 직접 통합하는 기술이다. NVIDIA Rubin(2026 후반~2027), Broadcom Tomahawk 6(2026), Apple AI 가속기(2027+)가 본격 채택 예정이다.
CPO가 OSAT에 주는 영향은 네 가지다. (1) 패키징 복잡도 폭증 — GPU + HBM + 광 모듈 통합으로 더 정밀한 본딩이 필요하다. (2) 새로운 부품 진입 — 광 칩, 레이저 다이오드, 광 도파로가 패키지 안으로 들어온다. (3) 수율 도전 — 광 정렬 정확도가 새로운 변수가 된다. (4) OSAT 차별화 가속 — CPO 경험 보유한 OSAT만 살아남으면서 Amkor·ASE의 우위가 강화된다. 한국 영향은 기존 한국 OSAT(하나마이크론·SFA반도체)에는 진입이 어렵지만 한미반도체 등 장비사에는 새로운 기회가 열린다는 것이다.
Hybrid Bonding — 차세대의 차세대
HBM4 이후의 HBM5(2028+)는 Hybrid Bonding을 채택할 가능성이 높다. 기존 HBM은 TSV + 마이크로 범프(솔더)를 사용하지만, Hybrid Bonding은 솔더 없이 구리-구리 직접 본딩 방식으로 더 가는 피치가 가능하며, 필요 정확도가 원자 단위(수 나노미터)에 이른다.
이 변화는 TC Bonder의 일부 대체 가능성을 의미한다. 한미반도체에는 도전, BESI(18% 점유)에는 기회다. 한미반도체는 자체 Hybrid Bonder를 개발 중이며, BESI는 이미 글로벌 Hybrid Bonding 1위로 차세대 본드의 게이트키퍼 위치에 있다.
FOPLP(Fan-Out Panel Level Packaging) — 패널 단위 패키징
기존 wafer 단위 대신 패널(직사각형) 단위로 패키징하는 기술이다. 면적이 더 크고 비용이 낮다. TSMC가 2027년부터 FOPLP 양산(WMCM이라고 부름)을 시작하고, Apple A20 Pro 등이 채택 예정이다. OSAT에 큰 외주 기회가 열리는 영역으로, TSMC가 자체로 다 못 커버하기 때문이다. Amkor의 외주 우선순위가 높고, 네패스아크가 한국에서 FOWLP 강자로 FOPLP 진입 가능성이 크다.
차세대 기술 로드맵
| 기술 | 본격 도입 | 한국 노출도 | 주요 수혜 |
|---|---|---|---|
| CoWoS-L | 2026 (NVIDIA Rubin) | 낮음 | TSMC + Amkor + ASE |
| CPO | 2026~27 | 중간 | CPO 광부품 + 통합 OSAT(Amkor·ASE) |
| FOPLP | 2027~ | 중간 | Amkor, 네패스아크, ASE |
| Hybrid Bonding (HBM4 시범) | 2026~ | 낮음 | TSMC 자체, 한미반도체 대응 |
| Hybrid Bonding (HBM5 양산) | 2028+ | 중간 | BESI(글로벌 1위), 한미반도체 신제품 |
| 3D Stacking (Logic on Logic) | 2027~ | 낮음 | TSMC, Intel |
- 본격 도입
- 2026 (NVIDIA Rubin)
- 한국 노출도
- 낮음
- 주요 수혜
- TSMC + Amkor + ASE
- 본격 도입
- 2026~27
- 한국 노출도
- 중간
- 주요 수혜
- CPO 광부품 + 통합 OSAT(Amkor·ASE)
- 본격 도입
- 2027~
- 한국 노출도
- 중간
- 주요 수혜
- Amkor, 네패스아크, ASE
- 본격 도입
- 2026~
- 한국 노출도
- 낮음
- 주요 수혜
- TSMC 자체, 한미반도체 대응
- 본격 도입
- 2028+
- 한국 노출도
- 중간
- 주요 수혜
- BESI(글로벌 1위), 한미반도체 신제품
- 본격 도입
- 2027~
- 한국 노출도
- 낮음
- 주요 수혜
- TSMC, Intel
결론 — 한국 투자 관점 7가지 + 모니터링 캘린더
핵심 7가지
1. AI 시대의 진짜 병목은 GPU 칩이 아니라 패키징(CoWoS)이다. NVIDIA·TSMC·Amkor 모두 공식 인정.
2. CoWoS 캐파는 3년 만에 13배 증가(10K → 130K/월)했지만 여전히 부족하다. 2026년부터 OSAT(Amkor·ASE·SPIL) 외주 본격화는 산업 격상의 단일 시그널이다.
3. 글로벌 OSAT은 대만이 압도(45.9%) + 중국이 부상(20%)한다. 한국은 변방 4%이지만 메모리 외주에서 강점이 있다. ASE 30%·Amkor 13.4% 양강 구도.
4. 한국 OSAT은 메모리 3사 HBM 집중의 반사수혜로 폭발적 회복 중이다. 하나마이크론 베트남 V2 4년 30배 성장이 그 증거다. 단 단일 고객 의존 리스크가 크다.
5. 한국의 진짜 챔피언은 한미반도체다. OSAT은 아니지만 TC Bonder 글로벌 70%+로 HBM 후공정 핵심이다. 단 SK하이닉스向 점유율은 ASMPT 침투(2025년 12월)로 2026년 20~30%로 분할되는 흐름이며, HBM5 Hybrid Bonder 신제품이 다음 라운드의 변수다.
6. Amkor K5(인천)가 글로벌 첨단 패키징 거점화됐다. CoWoS-S + Intel EMIB + Apple WMCM + Google TPU를 동시 운영하며, 한국에 위치한 외국인(미국) 회사이지만 한국 산업 인프라의 직접 수혜자다.
7. 차세대 4대 기술(CoWoS-L · CPO · FOPLP · Hybrid Bonding) 도입에 따라 산업 지도가 한 번 더 재편될 예정이다. 2027~28이 변곡점이다.
한국 투자 관점 — 3축 분산
(1) HBM 장비 — 한미반도체(TC Bonder, ASMPT 압박은 있지만 글로벌 70%+) · 이오테크닉스(레이저 장비) · BESI(Hybrid Bonding 1위, 네덜란드/EU). 단일 점유 변동 리스크 분산.
(2) 메모리 OSAT 외주 — 하나마이크론(SK하이닉스 의존 + 베트남 V2) · SFA반도체(삼성 + 필리핀 회복). 메모리 사이클 베타.
(3) 패키징 검사·테스트 — 인텍플러스(검사 장비) · FormFactor(프로브카드) · Aehr Test(번인) · Advantest(글로벌 ATE 1위) · 리노공업·ISC·테크윙. 분산된 specialty 모음.
글로벌 관점에서는 Amkor의 K5(인천)·애리조나가 CoWoS-S/EMIB 외주의 최대 수혜이며, ASE는 자체 VIPack·CoWoP 같은 차세대로 차별화를 시도한다. BESI는 Hybrid Bonding 1위로 차세대 본드의 게이트키퍼다.
모니터링 캘린더
| 시점 | 모니터링 항목 | 이유 |
|---|---|---|
| 매분기 | TSMC 가이던스 — CoWoS 캐파 + 외주 비중 | 산업 전체 수요·공급 |
| 매분기 | Amkor 분기 실적 — K5 가동률, AI 매출 비중 | OSAT 외주 본격화 트래킹 |
| 매분기 | 하나마이크론·SFA반도체 분기 실적 — V2/필리핀 가동률 | 한국 OSAT 펀더멘털 |
| 매분기 | 한미반도체 분기 실적 — TC Bonder 수주 잔고 + ASMPT 점유율 추이 | TC Bonder 시장 분할 진단 |
| 2026 하반기 | NVIDIA Rubin 출시 (CoWoS-L 본격화) | 차세대 OSAT 외주 흐름 |
| 2026~27 | Broadcom Tomahawk 6 (CPO 본격화) | 광 패키지 전환 시작 |
| 2027 | TSMC FOPLP/WMCM 양산 시작 | OSAT 외주 비중 추가 확대 |
| 2028 | HBM5 Hybrid Bonding 양산 | TC Bonder 시장 변곡점 |
- 모니터링 항목
- TSMC 가이던스 — CoWoS 캐파 + 외주 비중
- 이유
- 산업 전체 수요·공급
- 모니터링 항목
- Amkor 분기 실적 — K5 가동률, AI 매출 비중
- 이유
- OSAT 외주 본격화 트래킹
- 모니터링 항목
- 하나마이크론·SFA반도체 분기 실적 — V2/필리핀 가동률
- 이유
- 한국 OSAT 펀더멘털
- 모니터링 항목
- 한미반도체 분기 실적 — TC Bonder 수주 잔고 + ASMPT 점유율 추이
- 이유
- TC Bonder 시장 분할 진단
- 모니터링 항목
- NVIDIA Rubin 출시 (CoWoS-L 본격화)
- 이유
- 차세대 OSAT 외주 흐름
- 모니터링 항목
- Broadcom Tomahawk 6 (CPO 본격화)
- 이유
- 광 패키지 전환 시작
- 모니터링 항목
- TSMC FOPLP/WMCM 양산 시작
- 이유
- OSAT 외주 비중 추가 확대
- 모니터링 항목
- HBM5 Hybrid Bonding 양산
- 이유
- TC Bonder 시장 변곡점
피어 비교 분석
SK하이닉스 vs 삼성전자 vs MU 비교
밸류에이션 민감도
SK하이닉스 핵심 변수별 목표가 민감도
현재 주가
1,447,000원
조정 목표가
NaN원
(기본 대비 NaN%)
업사이드
NaN%
슬라이더를 조절하여 핵심 변수 변화에 따른 목표가 변동을 확인하세요
MU 핵심 변수별 목표가 민감도
현재 주가
$576.45
조정 목표가
$NaN
(기본 대비 NaN%)
업사이드
NaN%
슬라이더를 조절하여 핵심 변수 변화에 따른 목표가 변동을 확인하세요
관련 투자 아이디어
Amkor Technology — 2.5D/3D 패키징 OSAT 최대 수혜
ASE Technology — 글로벌 OSAT 1위의 첨단 패키징 레버리지
ASMPT — 어드밴스드 패키징 장비, BESI 추격자
BESI — 하이브리드 본딩 장비 글로벌 1위, 차세대 패키징 게이트키퍼
한미반도체 — HBM용 TC 본더 글로벌 1위
TSMC — CPO 패키징의 플랫폼, COUPE로 표준 장악
SK하이닉스 — HBM 글로벌 1위, 메모리 슈퍼사이클 최대 수혜
Micron — HBM3E 본격 출하, 미국 메모리 대표주자
FormFactor — HBM 테스트 병목을 겨냥한 프로브카드 리더
Aehr Test — SiC·HBM 번인 테스트의 니치 플레이
Advantest — 메모리·SoC 테스터 글로벌 1위, HBM 테스트 수혜
Lam Research — 식각·증착 장비 메모리 1위, HBM 직접 수혜
Intel — 18A 노드·파운드리 턴어라운드, 어드밴스드 패키징 수주 폭발
HPSP — 고압 어닐링 글로벌 독점, 메모리·로직 EUV 시대 필수
인텍플러스 — 패키징 검사 장비 강자, FC-BGA·HBM 동시 수혜
이수페타시스 — AI 가속기 고다층 PCB 글로벌 빅3
관련 ETF
이 리포트의 테마를 다루는 ETF 큐레이션. 보유종목·성과는 운용사 팩트시트 참조.
- 396500KRTIGER Fn반도체TOP100.45% · 10.4조Sat KR
- 091160KRKODEX 반도체0.45% · 5.2조Core KR
- 395160KRKODEX AI반도체0.45% · 2.5조Sat KR
- 456600KRTIMEFOLIO 글로벌AI인공지능액티브0.80% · 1.8조active-global
- 0167A0KRSOL AI반도체TOP2플러스0.45% · 1.1조Core KR
- 471990KRKODEX AI반도체핵심장비0.39% · 5,628.36억Core KR
- 455850KRSOL AI반도체소부장0.45% · 3,496억specialty-kr
- 485540KRKODEX 미국AI테크TOP100.30% · 3,032.438억Sat KR
댓글
본 리포트는 정보 제공 목적으로 작성되었으며, 특정 금융상품의 매수 또는 매도를 권유하지 않습니다. 투자 결정은 본인의 판단과 책임 하에 이루어져야 하며, 본 콘텐츠에 포함된 분석과 의견은 작성 시점의 정보를 바탕으로 한 것으로, 향후 변경될 수 있습니다.